With the rapid development of high-performance computing and artificial intelligence, there is a growing demand for high-bandwidth memory (HBM). HBM's high speed, high capacity, and low power consumption make it the memory solution of choice for high-end computing devices. However, as technology advances and the market demands for higher memory density, HBM manufacturers face new challenges. In this context, Liquid Mold Underfill (LMUF) technology has emerged as a key choice in HBM's manufacturing process. Here are a few of the main reasons why HBM manufacturers choose LMUF.
Improves heat conductivity
The stacking technology of HBM memory requires an increase in the number of DRAM layers while maintaining the standard package height. This makes the heat dissipation of the stacked chips a significant challenge. SK hynix and other companies use liquid epoxy molding compound (Liquid EMC) as the bottom filler, which doubles the thermal conductivity compared to conventional non-conductive films (NCF), effectively improving the heat dissipation efficiency of chips.
Increase memory density
Liquid molding underfiller technology allows manufacturers to create thinner DRAM layers without sacrificing performance or throughput and increase the number of DRAM layers by reducing interlayer space. This not only increases the overall density of the memory module, but also helps to achieve higher memory capacity.
Simplify the assembly process
Mass Reflow Molded Underfill (MR-MUF) technology with liquid molding underfill allows multiple DRAM chips to be bonded at once during the reflow process, while filling gaps between the chips. This technology simplifies the assembly process and increases production efficiency.
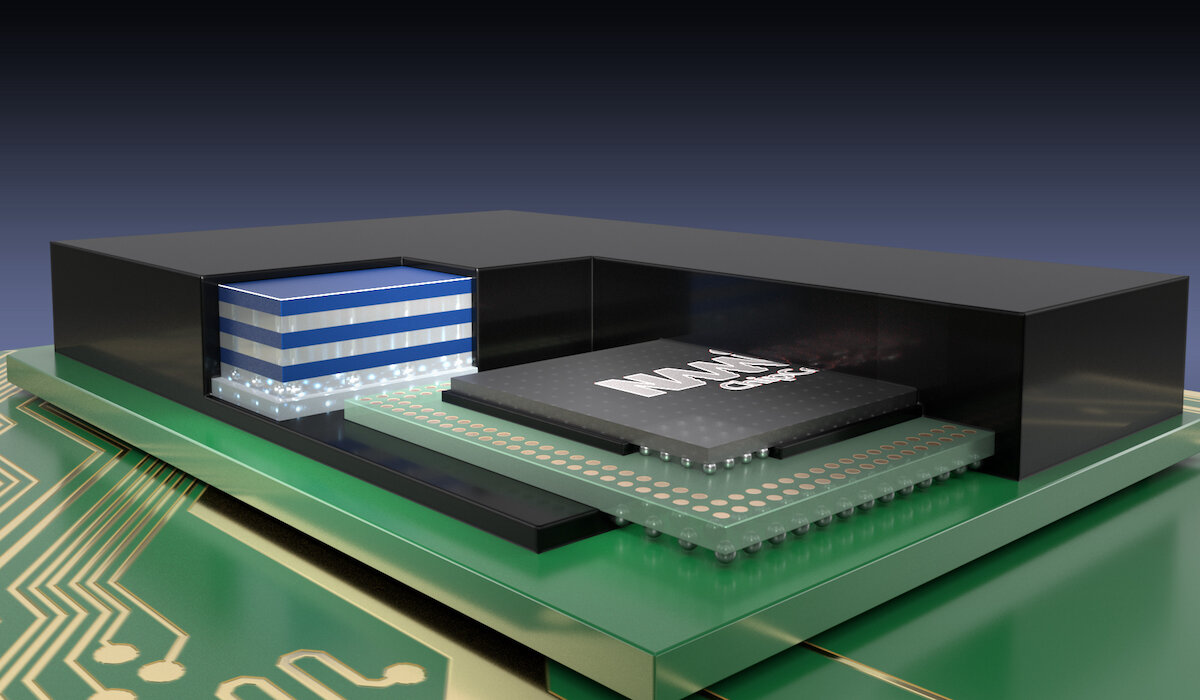
Figure: LMUF: A new choice for HBM manufacturers
Improve reliability
Liquid molding compound underfiller materials are known for their high reliability, which is critical to ensure the long-term stability and performance of HBM products.
Cost and throughput efficiency
The use of fillers under liquid molding compounds can help reduce costs and increase production throughput. It also supports thinner package designs, which is essential for the miniaturization of electronic devices.
Accommodates narrow spacing
The ability of liquid compression molding compound underfiller (LCMUF) to flow into narrow spacing is critical to meeting the fine spacing requirements of modern HBM stacking.
Improved subcapillary filler flow and production efficiency
Liquid molding underfiller is particularly suitable for flip chip packaging because it combines underfiller and topmold to improve capillary underfiller flow and increase productivity.
In summary, liquid molding compound underfiller technology has become the preferred choice of HBM manufacturers due to its advantages in thermal management, memory density, production efficiency, and reliability. As technology continues to advance, we can expect liquid molding compound underfillers to play an increasingly important role in future high-performance memory solutions.






